在开始之前,我们先要了解芯片中的“层”是什么概念。
芯片设计采用分层方法,对应制造过程中的不同功能结构。例如掩模版中的图形层、晶圆上的材料层(如金属层、多晶硅层、介质层)等。
其中PCB电路版图是我们芯片设计的最终结果。电路版图是芯片设计的物理表达,其每一层设计(如金属连线层)对应一张掩模版。通过光刻工艺,掩模版图形被转移到硅晶圆上,形成实际的物理层。
如下图左侧所示是晶体管设计版图,取自电路版图的一部分。
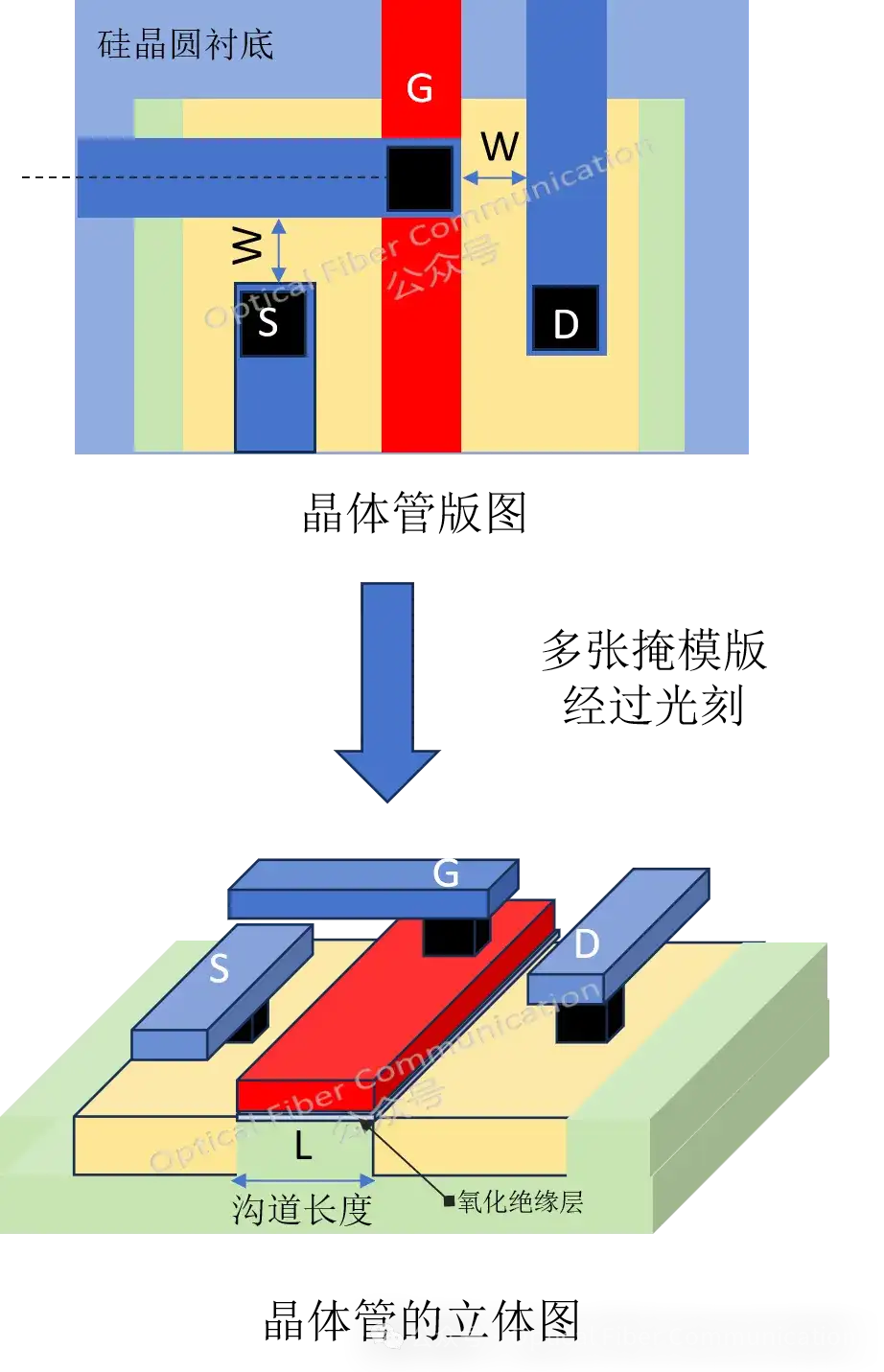
不同的颜色代表不同的层,也对应着相应的掩模版,每张掩模版经过光刻后会晶圆上形成材料介质层。电路版图中的每一层设计(如金属层、多晶硅层)对应一张掩模版,电路版图有多少层,最终晶圆上就有多少层的材料介质层。
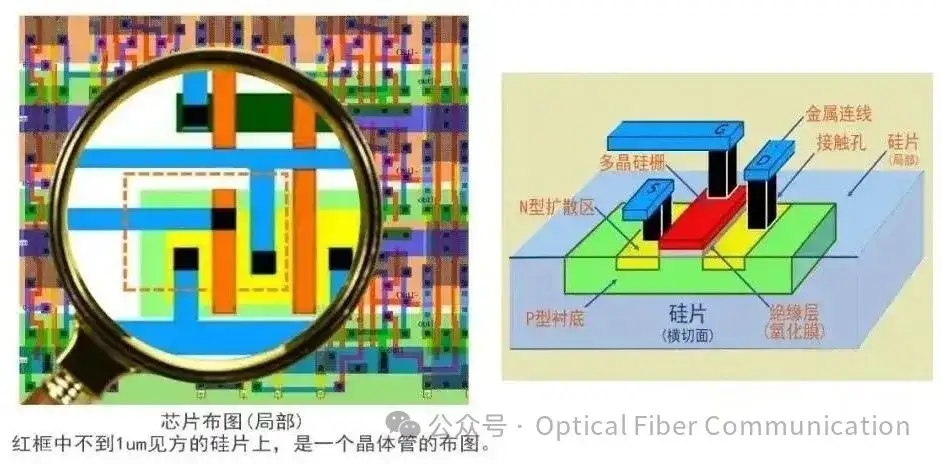
这些材料介质层在硅晶圆上叠加在一起,就形成了整个芯片上,乃至整个硅晶圆上所有的电路元器件和电路连线,称之为电路层。这里需明确:一个裸片本身已包含完整的多层电路结构(如晶体管层、金属互连层)。不像有的地方说的一个裸片上只有一层电路层。
这些元器件上面不再有元器件的堆叠。经过电路层制造、划片、封装和测试,就形成了我们的传统的2D芯片。
在2D芯片中,多个裸片是平铺到硅片上的,指未堆叠的单个封装体。

我们在2D芯片的电路层和封装基板之间增加一层专门用于布线的硅中介层,即Silicon Interposer,裸片堆叠到中介层上,硅中介层通过TSV实现芯片与基板的垂直互连,这样的芯片我们称之为2.5D芯片。
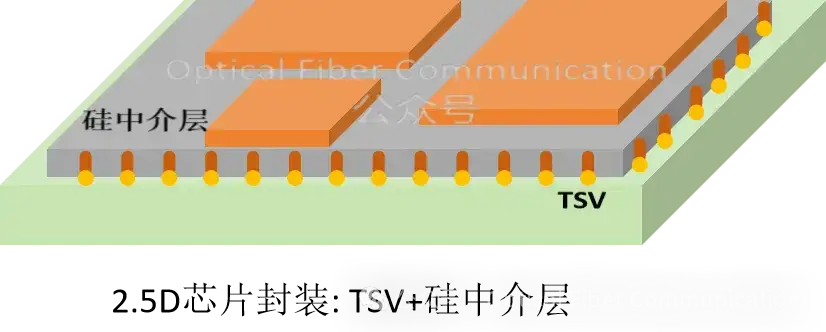
需要注意的是2.5D芯片中裸片本身不垂直堆叠。
而3D芯片指的是多个电路层堆叠起来的,每个裸片上都有一个电路层。但也2.5D芯片不同的是,在3D封装中,TSV直接在芯片上实现多层硅晶圆的垂直互连。如下图所示:
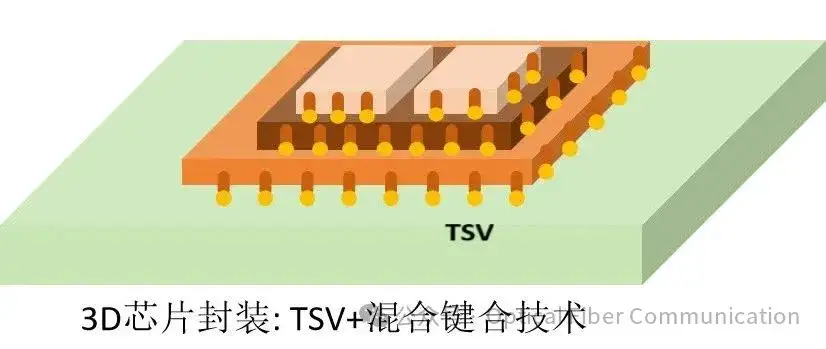
我们作个比喻:22D芯片如单层平房;2.5D如带阁楼的复式(中介层=楼梯);3D封装如多层公寓。
这里我们提一下存储芯片,虽然它的封装壳中中有一个裸片,但如果在此裸片上集成了很多电路层,那么存储芯片也可以被看作是3D芯片。2021年美光公司推出了176层的3D NAND闪存芯片。
不过,需要注意的,3D NAND是单颗裸片内部的垂直堆叠(属于芯片制造工艺),而3D封装是多颗完整裸片的垂直堆叠(属封装技术),二者层级上还是不同的。
感谢阅读,若有表述不准确地方,请指正~